请在线提交您的留言,我们将尽快联系您!

作者:
硅通孔技术根据字面意思和电镀铜的填充方式可以分为两大类:一种是深径比(Aspect Ratio)较小的,孔铜为等壁生长的TSV镀铜,如影像传感器、指纹识别芯片的封装大多依照该方式进行;另一种是超级填充(Super Filling)电镀铜的TSV,以MEMS等为代表。CIS(CMOS Image Sensor)的TSV封装工艺是属于TSV狭义概念的硅通孔工艺,通过硅穿孔将上下线路连通达成目的,还没有上升到3D集成的高度,与行业内SiP所讲的TSV系统集成的概念有所区别。但CIS封装是目前一个重要的封测工艺组成部分,本文将其纳入TSV范畴予以阐述。
影像传感器是将光信号转换为电信号的装置。影像传感芯片主要有两种:CCD和CMOS,前者由光电耦合器件构成,后者由金属氧化物器件构成。与CCD相比,CMOS影像传感器具有图框显示率快、高度的整合性(可减少周边组件使用量,降低系统成本),以及较低的功耗等特性,且CIS是标准工艺制程,在制造成本、产品售价方面具有明显的优势,因此CIS近年来在照相手机应用中得到快速发展。从2007年3月日本东芝公司首次采用TSV技术的晶圆级封装的小型影像传感器模组开始至今,这项技术不断吸引全球主要影像传感器厂商陆续投入以TSV制造照相模组的行列。2008年全球CIS出货数首次超越CCD影像传感器出货数。近几年,随着CIS技术的发展,CCD技术在市场中所占比重已大幅下降。CMOS影像传感器(CIS)是模拟电路和数字电路的集成,主要由四个组件构成:微透镜、彩色滤光片(CF)、光电二极管(PD)、像素设计。
影像传感器的蓬勃发展,大部分受益于照相手机(Camera Phone)。手机从之前打电话、发信息单一功能的“大哥大”走向了多媒体功能,可以满足音乐、视频、上网、拍照、办公和娱乐等需求。2000年,夏普首次推出可拍照的手机,随后智能手机时代到来,主摄像头像素不断提升,摄像头从单一走向了双摄和多摄。尽管2019年智能手机销量低迷,但手机影像传感器的销售却实现约20%的增长。另外随着安全监控市场的兴起,全球汽车电子、医疗器械、军用领域也为影像传感器创造可观的应用规模,影像传感器市场的需求将不断攀升。2017年CMOS影像传感器同比增长达到20%, 2018年全球CIS市场规模155亿美元,预计2020年增长10%,达到170亿美元。鉴于影像传感器的迅猛发展,其芯片采用的TSV封装工艺(有别于传统的Bumping工艺)将成为封装行业的重要工艺组成部分。目前国内以华天科技为代表的数家企业均具有CIS封装工艺量产能力。
在该工艺流程(见下图)中出现的化学镍金制程,是属于凸块下金属化(Under-Bump Metallization, UBM)重要结构,化学镍金或者镍钯金工艺不仅仅针对CIS封装,一般作为打线、焊料或锡球置底的UBM都可以采用化学镍(钯)金提高可靠性。其中镍层为阻挡层,可以防止铝或者铜基材与焊料或金线的扩散;钯层具有双重作用,既为阻挡层进一步降低扩散,还具有良好的打线键合作用;金层具有良好的抗氧化能力,也具有良好的打线功能。化学镍金或者镍钯金是指在铜基或铝基的UBM焊盘上经过多道前处理后,利用化学镀的方式,先沉积一层2~5微米的镍,再沉积一层钯,钯表面再沉积一层金。对于一般产品,采用镍金结构即可满足要求,对于可靠性要求较高的产品,建议采用化学镍钯金结构。当应用于无铅焊料(SAC 305锡膏)焊接时,化学镍钯金的厚度为钯层0.05~0.1微米、金层0.05~0.1微米;当应用于打线键合时,化学镍钯金的厚度为钯层0.1~0.2微米、金层0.1~0.2微米(质量优先)或者金层0.05~0.1微米(成本考虑)。
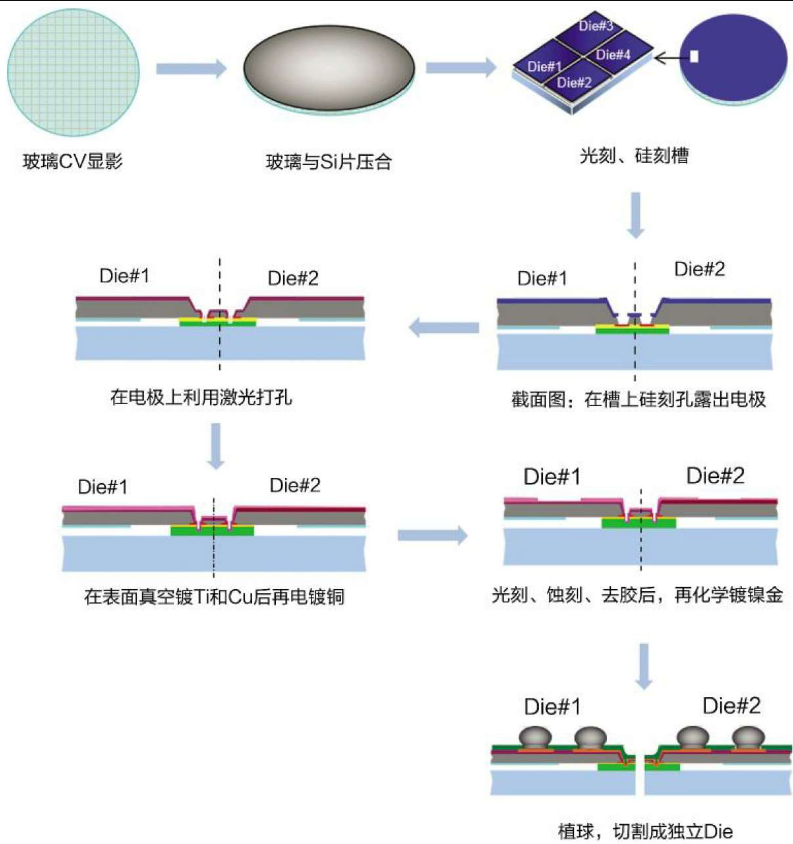
CIS封装工艺流程示意图
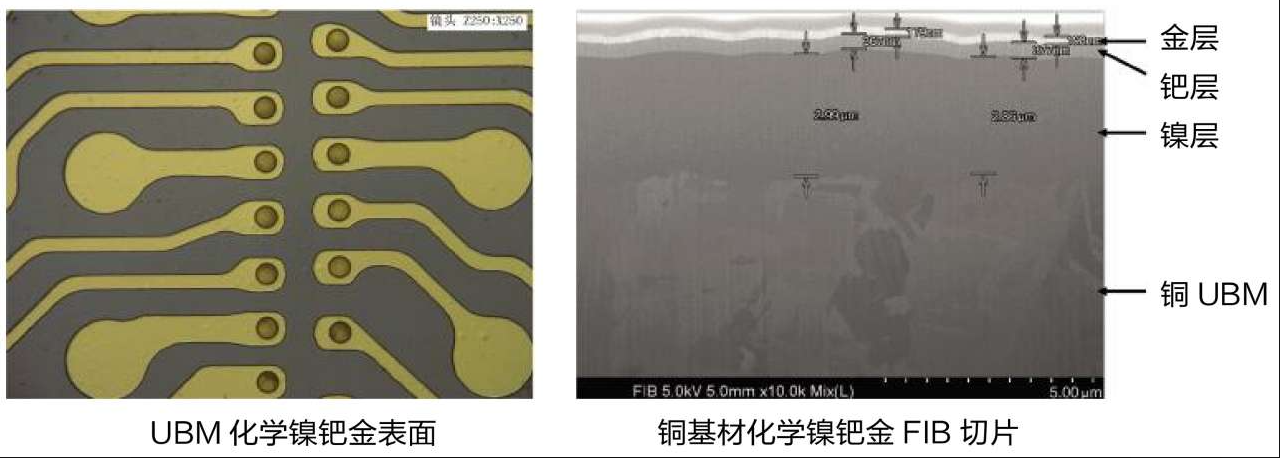
镍钯金化学镀示例图
长期以来,化学镀金往往采用氰化亚金钾作为主盐,随着环保要求日趋严格,行业内开始采用无氰化学金的方式代替氰化物镀金,并且已经有了成熟的市场应用案例。相对于电镀,化学镀的优点明显。化学镀对设备的要求较低,金槽开缸浓度低,镀层均一性好,可以节省金盐,降低成本。另外,化学镀生产效率较高,且化学镀区域可以是独立焊盘,不受图形线路限制。由于化学镀具有投资低的优势,近年来有人尝试利用化学镀铜的方式来代替真空镀铜。
如果您对这篇文章感兴趣,请立即联系我们
请在线提交您的留言,我们将尽快联系您!